SMT använder konventionell lödpasta, luftreflow-svetskavitetsanalys och lösning (2023 Essence Edition), du förtjänar det!
1 Introduktion

I kretskortsmonteringen trycks lödpasta först på kretskortets lödplatta, och sedan fästs olika elektroniska komponenter. Slutligen, efter reflowugnen, smälts tennpärlorna i lödpastan och alla typer av elektroniska komponenter och lödplattan på kretskortet svetsas samman för att åstadkomma monteringen av elektriska submoduler. Ytmonteringsteknik (sMT) används alltmer i högdensitetsförpackningsprodukter, såsom systemnivåpaket (siP), ballgridarray (BGA)-enheter och power bare Chip, fyrkantiga plana stiftlösa paket (quad aatNo-lead, kallad QFN)-enheter.
På grund av egenskaperna hos lödpastasvetsprocessen och materialen kommer det efter omsvetsning av dessa stora lödytor att finnas hål i lödsvetsområdet. Detta påverkar produktens elektriska, termiska och mekaniska egenskaper och kan till och med leda till produktfel. Därför har förbättringar av lödpastas omsvetsningskaviteten blivit ett process- och tekniskt problem som måste lösas. Vissa forskare har analyserat och studerat orsakerna till BGA-lödkulsvetsningskaviteten och tillhandahållit förbättringslösningar. Det saknas en lösning för det bara chipet vid konventionell lödpastas omsvetsning med en QFN-svetsarea större än 10 mm2 eller en svetsarea större än 6 mm2.
Använd preformlödsvetsning och vakuumrefluxugnssvetsning för att förbättra svetshålet. Prefabricerat löd kräver specialutrustning för att punktera flussmedlet. Till exempel förskjuts och lutas chipet kraftigt efter att chipet placerats direkt på det prefabricerade lodet. Om flussmonteringschipet omsmälts och sedan punkteras ökas processen med två omsmältningar, och kostnaden för prefabricerat löd- och flussmedelsmaterial är mycket högre än för lödpasta.
Vakuumåterflödesutrustning är dyrare, vakuumkapaciteten hos den oberoende vakuumkammaren är mycket låg, kostnadseffektiviteten är inte hög och problemet med tennstänk är allvarligt, vilket är en viktig faktor vid tillämpningen av produkter med hög densitet och liten stigning. I denna artikel utvecklas och introduceras en ny sekundär återflödessvetsningsprocess, baserad på den konventionella lödpasta-återflödessvetsprocessen, för att förbättra svetskaviteten och lösa problemen med bindning och sprickbildning i plasttätningen orsakad av svetskaviteten.
2 Lödpastautskrifts-omsvetsningshålighet och produktionsmekanism
2.1 Svetskammare
Efter omsvetsning testades produkten med röntgen. Hålen i svetszonen med ljusare färg visade sig bero på otillräcklig lödmängd i svetsskiktet, såsom visas i figur 1.
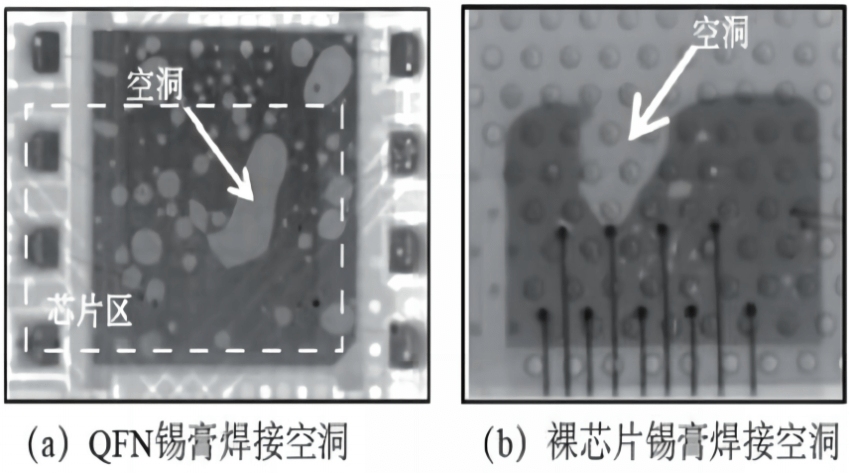
Röntgendetektering av bubbelhålet
2.2 Bildningsmekanism för svetshålighet
Med lödpasta sAC305 som exempel visas huvudkompositionen och funktionen i tabell 1. Flussmedlet och tennpärlorna är sammanbundna i pastaform. Viktförhållandet mellan tennlod och flussmedel är cirka 9:1 och volymförhållandet är cirka 1:1.

Efter att lödpastan har tryckts och monterats med olika elektroniska komponenter, genomgår lödpastan fyra steg: förvärmning, aktivering, återflöde och kylning när den passerar genom återflödesugnen. Lödpastans tillstånd varierar också med olika temperaturer i olika steg, såsom visas i figur 2.
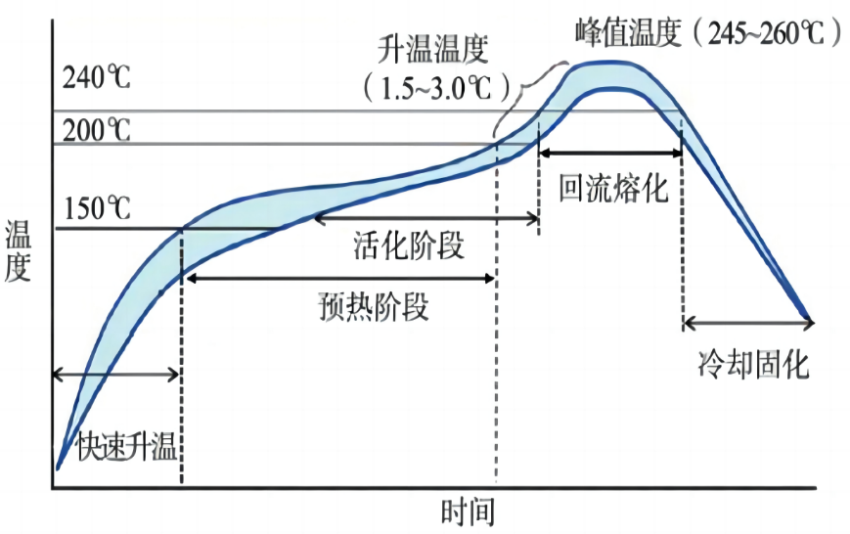
Profilreferens för varje område av reflowlödning
I förvärmnings- och aktiveringssteget förångas de flyktiga komponenterna i flussmedlet i lödpastan till gas vid uppvärmning. Samtidigt kommer gaser att produceras när oxiden på ytan av svetsskiktet avlägsnas. En del av dessa gaser förångas och lämnar lödpastan, och lödpärlorna kommer att kondenseras hårt på grund av flussmedlets förångning. I återflödessteget förångas det återstående flussmedlet i lödpastan snabbt, tennpärlorna smälter, en liten mängd flussmedelsflyktig gas och det mesta av luften mellan tennpärlorna kommer inte att dispergeras i tid, och resterna i det smälta tennet och under spänningen av det smälta tennet bildar en hamburger-sandwichstruktur och fångas upp av kretskortets lödplatta och elektroniska komponenter, och gasen som är insvept i det flytande tennet är svår att släppa ut endast på grund av den uppåtgående flytkraften. Den övre smälttiden är mycket kort. När det smälta tennet svalnar och blir fast tenn, uppstår porer i svetsskiktet och lödhål bildas, som visas i figur 3.
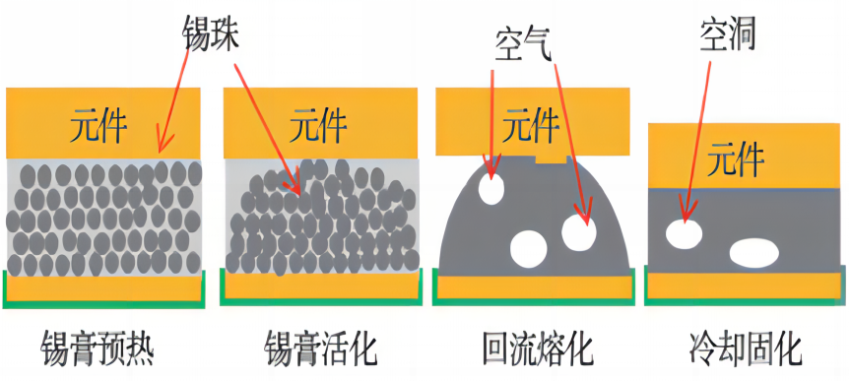
Schematisk bild av tomrum som genereras genom lödpasta-omsvetsning
Grundorsaken till svetshålighet är att luften eller den flyktiga gasen som är insvept i lödpastan efter smältning inte avleds helt. De påverkande faktorerna inkluderar lödpastans material, lödpastans tryckform, lödpastans tryckmängd, återflödestemperatur, återflödestid, svetsstorlek, struktur och så vidare.
3. Verifiering av påverkande faktorer för lödpastatryckning av reflow-svetshål
QFN- och barechip-tester användes för att bekräfta de huvudsakliga orsakerna till reflow-svetshålrum och för att hitta sätt att förbättra de reflow-svetshålrum som lödpastan producerar. Produktprofilen för QFN- och barechip-lödpastas reflow-svetsning visas i figur 4. QFN-svetsytans storlek är 4,4 mm x 4,1 mm, svetsytan är ett förtennat lager (100 % rent tenn). Svetsstorleken på det bara chipet är 3,0 mm x 2,3 mm, svetsskiktet är ett sputterat nickel-vanadin-bimetalllager och ytskiktet är vanadin. Svetsytan på substratet var elektrolös nickel-palladium-gulddoppning och tjockleken var 0,4 μm/0,06 μm/0,04 μm. SAC305 lödpasta används, lödpastatryckutrustningen är DEK Horizon APix, återflödesugnsutrustningen är BTUPyramax150N och röntgenutrustningen är DAGExD7500VR.
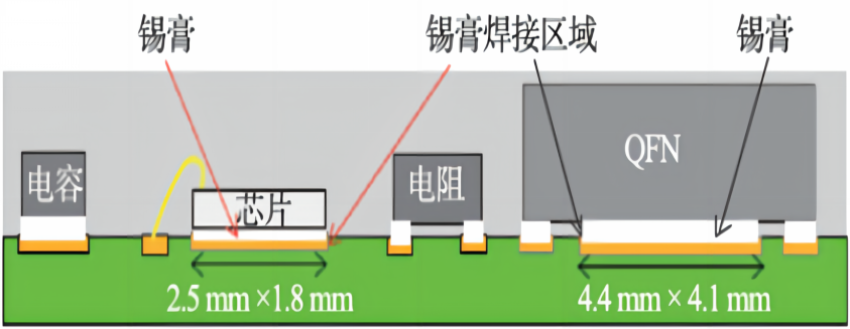
QFN- och svetsritningar för bara spån
För att underlätta jämförelse av testresultat utfördes reflow-svetsning under förhållandena i tabell 2.

Tabell för omsvetsningsförhållanden
Efter att ytmontering och omsvetsning var slutförd detekterades svetsskiktet med röntgen, och det konstaterades att det fanns stora hål i svetsskiktet längst ner på QFN och det bara spånet, såsom visas i figur 5.
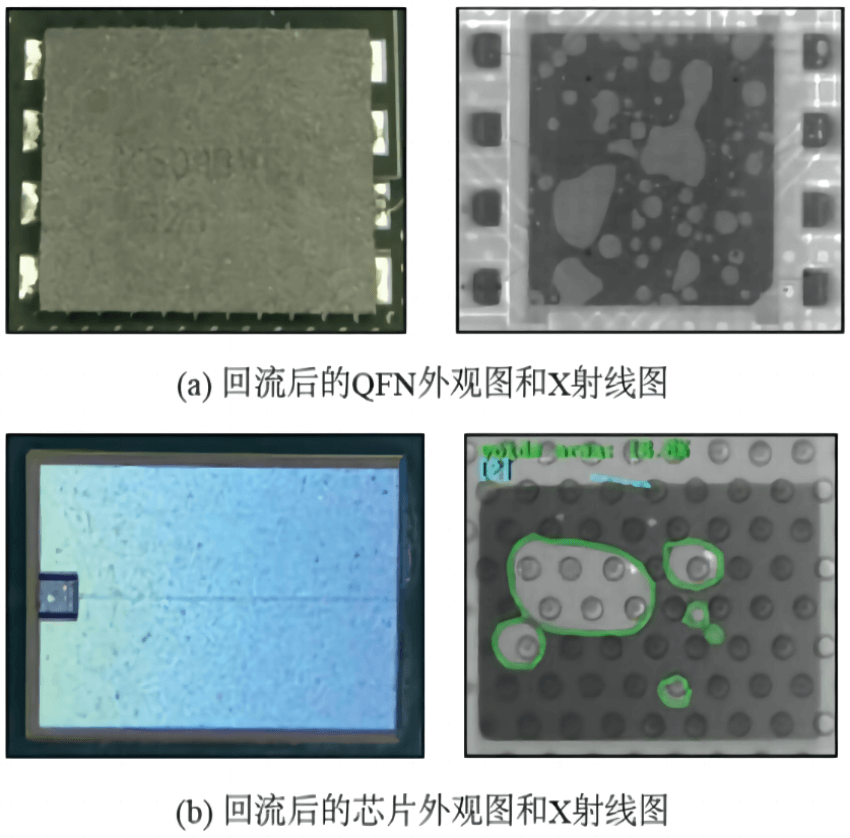
QFN och chiphologram (röntgen)
Eftersom tennpärlstorlek, stålnätets tjocklek, öppningsarean, stålnätets form, återflödestid och ugnens högsta temperatur alla påverkar svetshålrummen i återsmältningen, finns det många påverkande faktorer som kan verifieras direkt med DOE-test, och antalet experimentgrupper blir för stort. Det är nödvändigt att snabbt screena och bestämma de viktigaste påverkande faktorerna genom korrelationsjämförelsetest, och sedan ytterligare optimera de viktigaste påverkande faktorerna genom DOE.
3.1 Mått på lödhål och tennpärlor för lödpasta
Med lödpastest av typ 3 (pärlstorlek 25-45 μm) SAC305 förblir andra förhållanden oförändrade. Efter omsmältning mäts hålen i lödlagret och jämförs med lödpasta av typ 4. Det konstateras att hålen i lödlagret inte skiljer sig signifikant mellan de två typerna av lödpasta, vilket indikerar att lödpastan med olika pärlstorlek inte har någon uppenbar inverkan på hålen i lödlagret, vilket inte är en påverkande faktor, såsom visas i FIG. 6.

Jämförelse av hål i metalliskt tennpulver med olika partikelstorlekar
3.2 Tjocklek på svetshålighet och tryckt stålnät
Efter omsmältningen mättes kavitetsarean i det svetsade lagret med det tryckta stålnätet med tjocklekarna 50 μm, 100 μm och 125 μm, medan andra förhållanden förblev oförändrade. Det visade sig att effekten av olika tjocklekar på stålnätet (lödpasta) på QFN jämfördes med den för det tryckta stålnätet med en tjocklek på 75 μm. Allt eftersom stålnätets tjocklek ökar minskar kavitetsarean gradvis långsamt. Efter att ha nått en viss tjocklek (100 μm) kommer kavitetsarean att vända och börja öka med ökande tjocklek på stålnätet, såsom visas i figur 7.
Detta visar att när mängden lödpasta ökas, täcks den flytande tenn som återflödet sker av chipet, och utloppet för kvarvarande luft är endast smalt på fyra sidor. När mängden lödpasta ändras, ökar även utloppet för kvarvarande luft, och den omedelbara utbrottet av luft insvept i flytande tenn eller flyktig gas som läcker ut från flytande tenn kommer att orsaka att flytande tenn stänker runt QFN och chipet.
Testet visade att med ökande tjocklek på stålnätet ökar även antalet bubbelsprängningar orsakade av utsläpp av luft eller flyktig gas, och sannolikheten för att tenn stänker runt QFN och spån ökar också i motsvarande grad.

Jämförelse av hål i stålnät av olika tjocklek
3.3 Areaförhållande mellan svetshålighet och stålnätsöppning
Det tryckta stålnätet med öppningshastigheter på 100 %, 90 % och 80 % testades, och övriga förhållanden förblev oförändrade. Efter omsmältning mättes kavitetsarean i det svetsade lagret och jämfördes med det tryckta stålnätet med öppningshastigheten 100 %. Det konstaterades att det inte fanns någon signifikant skillnad i kaviteten i det svetsade lagret under förhållandena med öppningshastigheter på 100 % och 90 % och 80 %, såsom visas i figur 8.

Kavitetsjämförelse av olika öppningsarea hos olika stålnät
3.4 Svetsat hålrum och tryckt stålnätform
Med tryckformstestet av lödpastan på remsa b och det lutande gallret c förblir övriga förhållanden oförändrade. Efter omsmältning mäts kavitetsarean i svetsskiktet och jämförs med tryckformen på gallret a. Det konstateras att det inte finns någon signifikant skillnad i kaviteten i svetsskiktet under förhållandena med galler, remsa och lutande galler, såsom visas i figur 9.
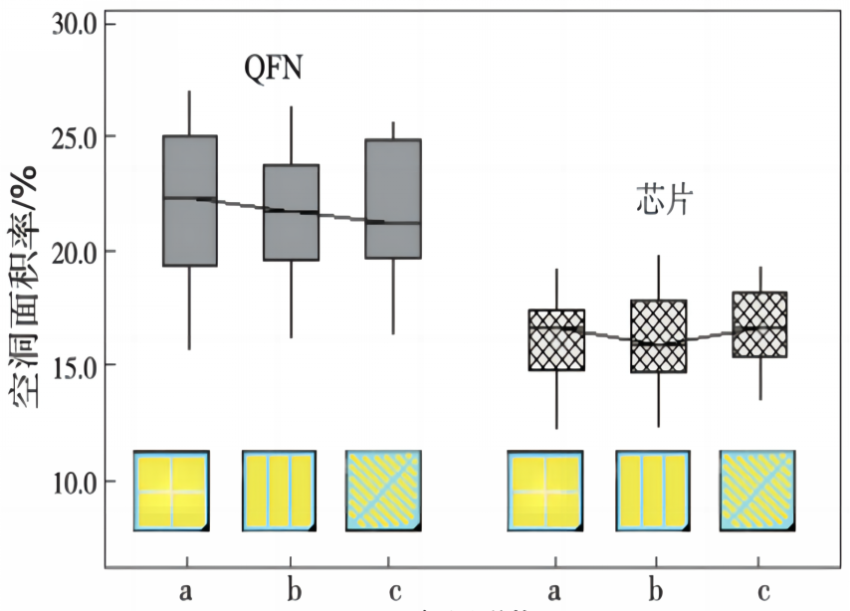
Jämförelse av hål i olika öppningslägen för stålnät
3.5 Svetskavitet och återflödestid
Efter test med förlängd återflödestid (70 s, 80 s, 90 s), medan andra förhållanden förblev oförändrade, mätte hålet i svetsskiktet efter återflödet och jämförde det med återflödestiden på 60 s. Det visade sig att med ökande återflödestid minskade svetshålets area, men reduktionsamplituden minskade gradvis med ökande tid, såsom visas i figur 10. Detta visar att vid otillräcklig återflödestid bidrar en ökning av återflödestiden till att luften som är insvept i smält flytande tenn rinner över fullt. Men efter att återflödestiden ökat till en viss tid är det svårt för luften som är insvept i flytande tenn att rinna över igen. Återflödestiden är en av faktorerna som påverkar svetskaviteten.

Jämförelse av olika refluxtidslängder
3.6 Svetskavitet och ugnens högsta temperatur
Med 240 ℃ och 250 ℃ toppugnstemperaturtest och andra förhållanden oförändrade, mättes kavitetsarean för det svetsade lagret efter återsmältning, och jämfört med 260 ℃ toppugnstemperatur fann man att kaviteten i det svetsade lagret av QFN och spån inte förändrades signifikant under olika toppugnstemperaturförhållanden, såsom visas i figur 11. Det visar att olika toppugnstemperaturer inte har någon uppenbar effekt på QFN och hålet i spånans svetsskikt, vilket inte är en påverkande faktor.

Ogiltig jämförelse av olika topptemperaturer
Ovanstående tester indikerar att de signifikanta faktorerna som påverkar svetsskiktets kavitet hos QFN och spånan är återflödestid och stålnätets tjocklek.
4 Förbättring av svetshåligheten vid reflow av lödpasta
4.1 DOE-test för att förbättra svetshåligheten
Hålet i svetsskiktet mellan QFN och chipet förbättrades genom att hitta det optimala värdet för de viktigaste påverkande faktorerna (återflödestid och stålnätets tjocklek). Lödpastan var SAC305 typ 4, stålnätets form var av rutnätstyp (100 % öppningsgrad), ugnens maximala temperatur var 260 ℃ och andra testförhållanden var desamma som för testutrustningen. DOE-test och resultat visas i tabell 3. Påverkan av stålnätets tjocklek och återflödestid på QFN- och chipsvetshål visas i figur 12. Genom interaktionsanalys av de viktigaste påverkande faktorerna har det visat sig att användning av 100 μm stålnätets tjocklek och 80 s återflödestid kan minska svetskaviteten för QFN och chipet avsevärt. Svetskavitetsgraden för QFN minskas från maximalt 27,8 % till 16,1 %, och svetskavitetsgraden för chipet minskas från maximalt 20,5 % till 14,5 %.
I testet producerades 1000 produkter under optimala förhållanden (100 μm stålnätstjocklek, 80 s återflödestid), och svetshålighetshastigheten för 100 QFN och spån mättes slumpmässigt. Den genomsnittliga svetshålighetshastigheten för QFN var 16,4 % och den genomsnittliga svetshålighetshastigheten för spån var 14,7 %. Svetshålighetshastigheten för spånan och spånan minskar uppenbart.

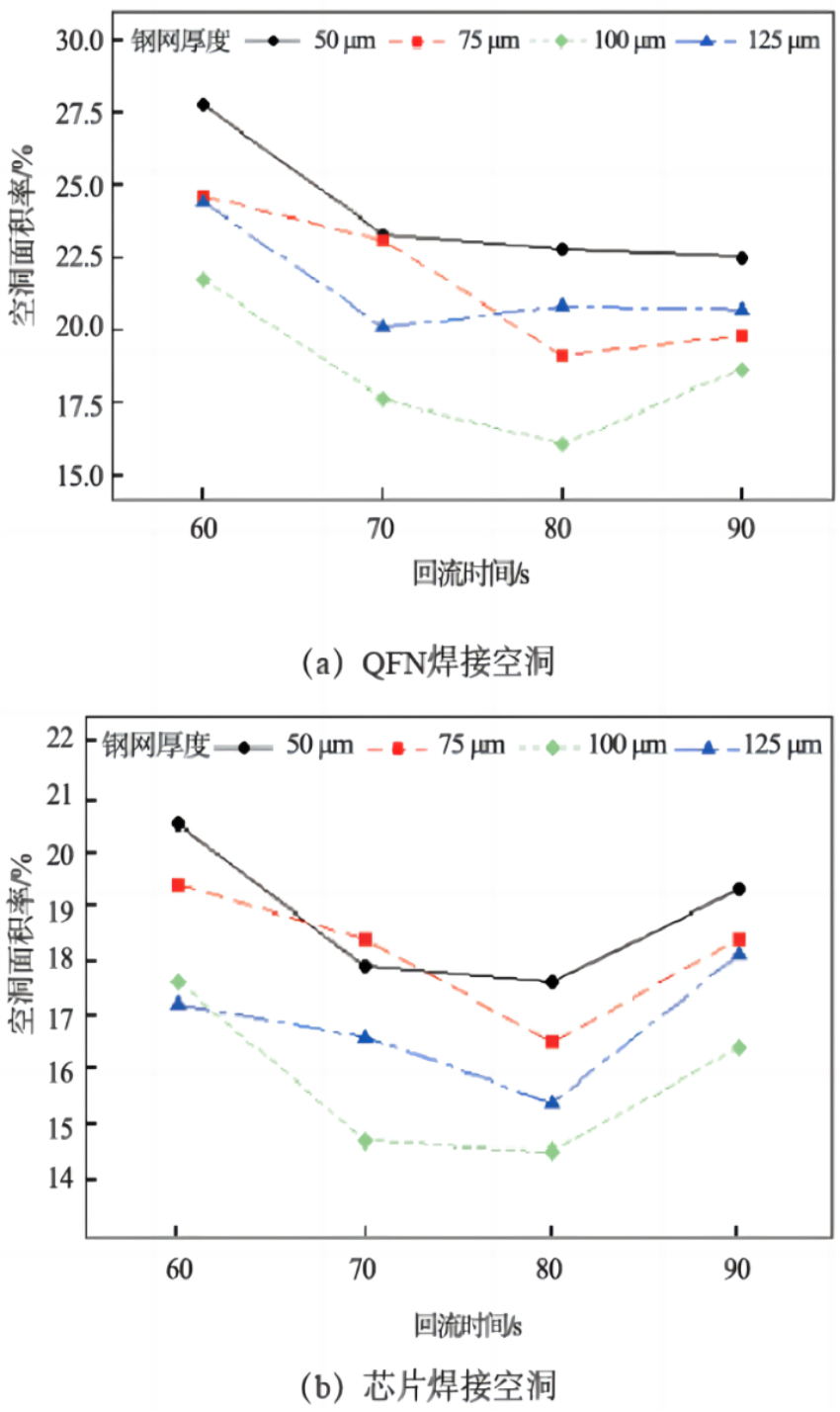
4.2 Den nya processen förbättrar svetshåligheten
Den faktiska produktionssituationen och testerna visar att när svetsarean i botten av chipet är mindre än 10 %, kommer problem med sprickbildning i chipets position inte att uppstå under bindning och gjutning av bly. De processparametrar som optimerats av DOE kan inte uppfylla kraven för att analysera och lösa hålen vid konventionell lödpastasvetsning, och chipets svetsarean behöver minskas ytterligare.
Eftersom chipet som är täckt av lödmetallen förhindrar att gasen i lödmetallen läcker ut, minskas hålfrekvensen i chipets botten ytterligare genom att eliminera eller minska den lödbelagda gasen. En ny process för omsvetsning med två lödpastatryck har antagits: en lödpastatryckning, en omsvetsning som inte täcker QFN och det bara chipet som släpper ut gasen i lödmetallen. Den specifika processen för sekundär lödpastatryckning, patch och sekundär återflöde visas i figur 13.
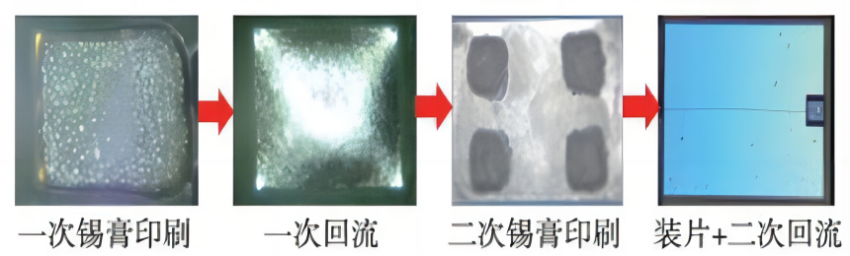
När den 75 μm tjocka lödpastan trycks för första gången, slipper det mesta av gasen i lödningen utan spånskydd från ytan, och tjockleken efter återflödet är cirka 50 μm. Efter avslutad primäråterflöde trycks små fyrkanter på ytan av det kylda stelnade lödningen (för att minska mängden lödpasta, gasspill, eller eliminera lödstänk), och lödpastan läggs i en tjocklek på 50 μm (testresultaten ovan visar att 100 μm är bäst, så tjockleken på den sekundära tryckningen är 100 μm = 50 μm), sedan installeras spånet och återförs sedan efter 80 sekunder. Det finns nästan inget hål i lödningen efter den första tryckningen och återflödet, och lödpastan i den andra tryckningen är liten och svetshålet är litet, som visas i figur 14.
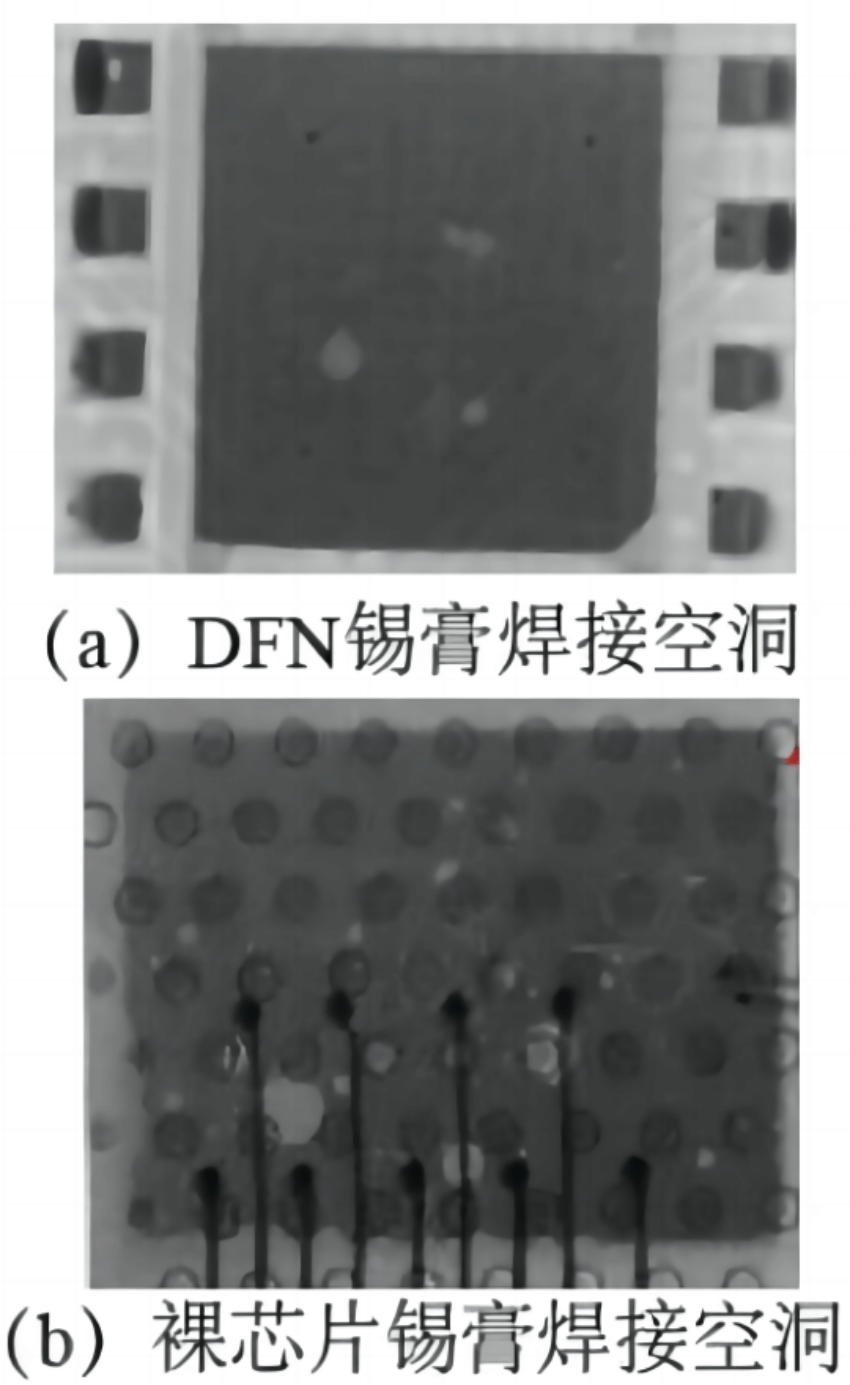
Efter två tryck av lödpasta, ihålig ritning
4.3 Verifiering av svetshålighetens effekt
Produktion av 2000 produkter (tjockleken på det första tryckstålsnätet är 75 μm, tjockleken på det andra tryckstålsnätet är 50 μm), andra förhållanden oförändrade, slumpmässig mätning av 500 QFN och spånsvetsningshastighet, fann att den nya processen efter den första återflödet ingen kavitet, efter den andra återflödet av QFN är den maximala svetskavitetshastigheten 4,8%, och spånans maximala svetskavitetshastighet är 4,1%. Jämfört med den ursprungliga enkelpasta-trycksvetsprocessen och den DOE-optimerade processen, minskas svetskaviteten avsevärt, såsom visas i figur 15. Inga spånsprickor hittades efter funktionstester av alla produkter.

5 Sammanfattning
Optimering av mängden lödpasta som trycks ut och återflödestiden kan minska svetshålighetens area, men svetshålighetens hastighet är fortfarande stor. Användning av två lödpastatrycktekniker för omflödessvetsning kan effektivt maximera svetshålighetens hastighet. Svetsarean för ett QFN-kretschip kan vara 4,4 mm x 4,1 mm respektive 3,0 mm x 2,3 mm vid massproduktion. Hålighetens hastighet vid omflödessvetsning kontrolleras till under 5 %, vilket förbättrar kvaliteten och tillförlitligheten hos omflödessvetsningen. Forskningen i denna artikel ger en viktig referens för att förbättra svetshålighetsproblemet vid stora svetsytor.






